
- ホーム
- >
- ニュース
- >
- 半導体産業におけるXRD技術の応用
- >
半導体産業におけるXRD技術の応用
2023-09-20 10:00世界の半導体装置支出は上昇サイクルに入った。5G、モノのインターネット、ビッグデータ、人工知能、自動車エレクトロニクスなどの新技術や新製品の応用は、半導体市場に巨大な需要をもたらし、業界は新たな上昇サイクルに入るだろう。産業チェーン全体のフロントエンドにおけるウェーハ生産、エピタキシャル成長、パッケージングと統合、およびそのプロセスと製品品質は、下流の産業アプリケーションに直接関係しています。リガクでは以下のような設備を完備しています。X線回折(XRD)、蛍光X線(XRF)、X 線反射率計 (XRR) および X 線トポグラフィー (XRT) は、ウェーハ製造から集積回路までのプロセス全体に適用でき、厚さなどのいくつかの重要なプロセス パラメータを非破壊で測定できます。 、組成、粗さ、密度、気孔率、および結晶構造そして結晶構造の欠陥。
1. ウェーハ製造において、欠陥の数と種類はその後の工程に大きな影響を与えます。X線トポロジカルイメージング(XRT)では、ウェーハ表面の欠陥や転位を鮮明に観察できます(図1)。生産者がプロセスを改善し、品質を管理できるように支援します。
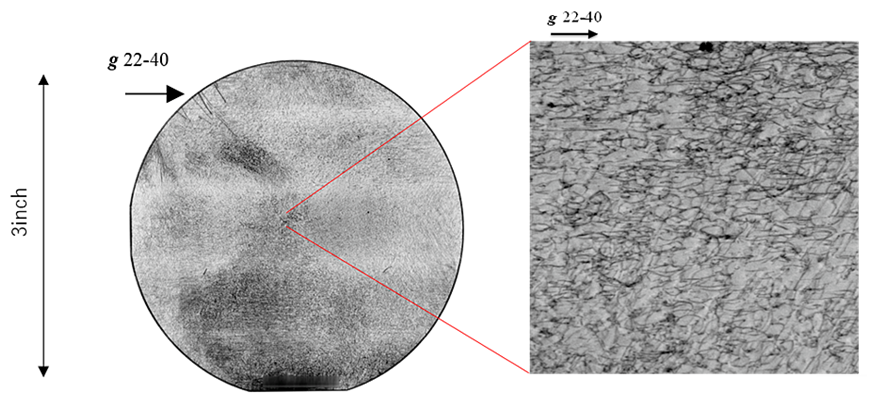
図 1: 4H-シック ウェーハの伝送トポロジーのイメージング
2. ウェーハまたはエピタキシャル膜の均一性は次のように測定できます。XRDスイングカーブ機能を搭載しており、リガクが提供する可視化ソフトウェアモジュールにより二次元分布画像も得られ、直感的に表面の品質を評価することができます(図2)。
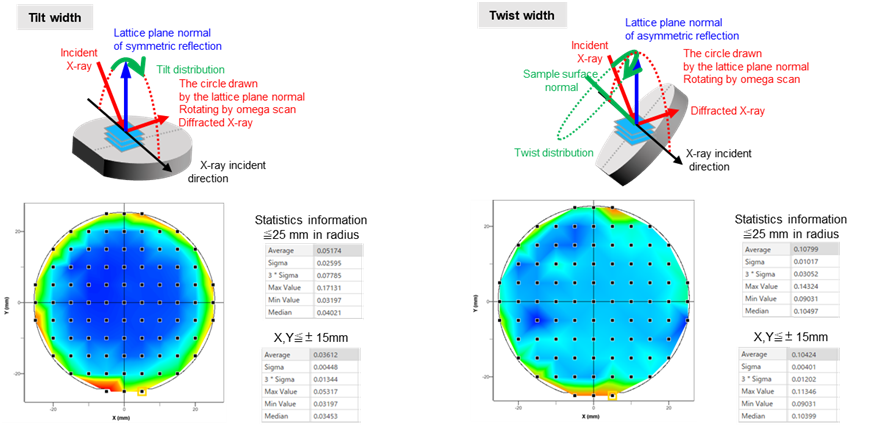
図2: サファイア基板上に成長したAlN膜の二次元画像
3. フィルムの厚さは、非破壊で高精度な高分解能スイングカーブによって測定できます (図 3)。

図 3: GaN/InxGa(1-x)N 膜の厚さを測定するための高分解能スイング曲線
4. ウェーハまたはエピタキシャル膜の成長中にある種の格子不整合が発生する可能性があり、膜の品質に影響を及ぼします。リガクの特別な検出器とソリューションを使用すると、スマートラボ で相互空間テストを実行できます。結晶学的定数は非常に直感的に見ることができます。
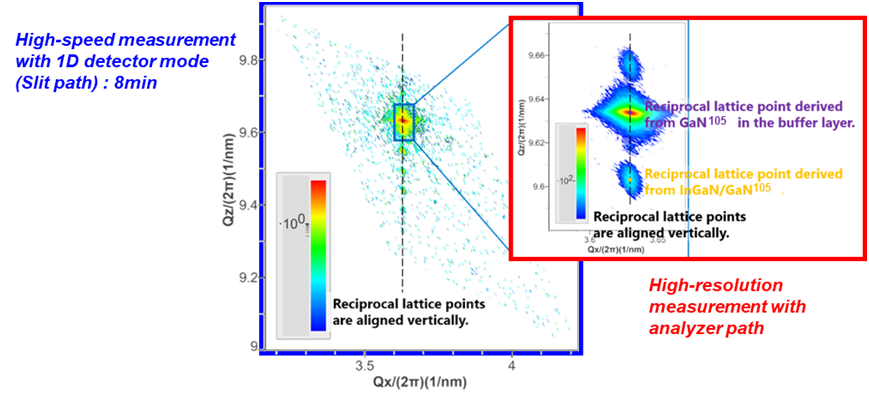
図 4: GaN105 の高分解能逆空間スペクトル
