
化合物半導体の高分解能X線回折(人事部-XRD)測定
2023-09-16 10:00高分解能XRD(人事部-XRD)は、シゲ、AlGaAs、InGaAsなどの化合物半導体の組成と厚さを測定するための一般的な方法です。
ドーパントや不純物が添加されると、単結晶格子を変位させると、ドーピング原子の存在により格子が歪みます。たとえば、シ 格子では、ゲ 原子が格子内で シ 原子よりも大きいため、ゲ 原子の存在により圧縮歪みが生じます。このひずみにより シ 格子の間隔が変化し、この間隔の違いは 人事部-XRD によって検出できます。

図 1: シ 基板上の 10nm シゲ 層など、圧縮歪み下の一般構造の理論上の 人事部-XRD スキャン。0 度のスパイクは、基板内の シ 格子から生じます。
より大きな ゲ 原子が存在すると、シゲ 層内の シ 原子がさらに離れ、回折ピークがより低い角度 (基板ピークの左側) にシフトします。10nmのSiGe層は薄いため、SiGe層の回折ピークはSi基板の回折ピークよりもはるかに幅が広くなります。
このような膜では、回折信号を生成するために使用できるのは、特定の配置を持つ数列の原子だけです。X線回折回折信号の原子列を生成するために使用できる基板内に数千の行があるため、ピークは シ 基板からの回折よりも幅が広くなります。構造に引張歪みがかかっている場合、シ 原子の間隔は基板内の シ 原子よりも近くなり、対応する回折ピークは基板のピークの右側に移動します。スペクトル内の余分なピークは、"厚みのある縞模様、"これは、シゲ 層と シ 基板の間の界面で反射された X 線の干渉が強化されることに起因します。これは、X 線反射率 (XRR) 解析に使用される信号と同じであり、歪み層の厚さを決定するために使用できます。
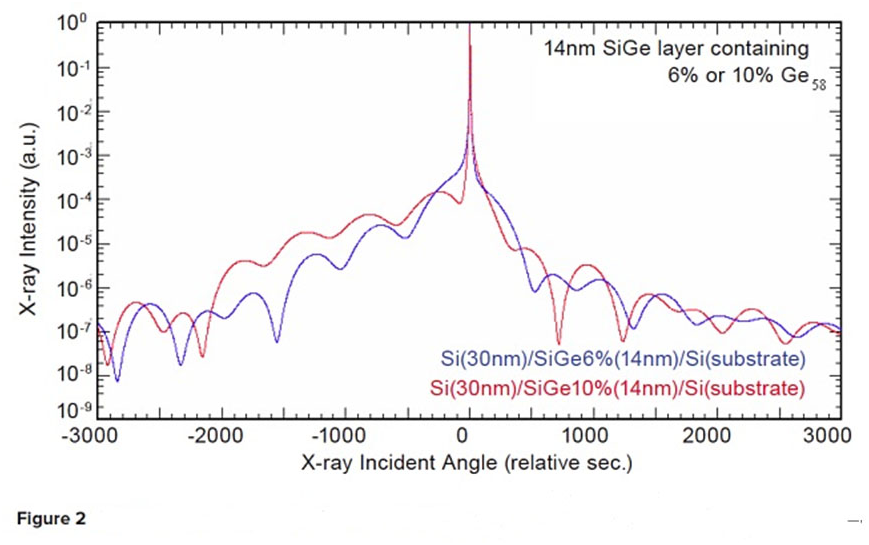
この方法は、歪み層の組成を決定するために使用できます。図 2 は、シ 基板上の 14nm シゲ 上の 30nm シ から成長させた 2 つのサンプルの理論的な 人事部-XRD スキャンを示しています。最初のケースでは格子内に 6% の ゲ が存在し、もう 1 つのケースでは 10% の ゲ が存在します。人事部-XRD は、これら 2 つの構造の違いを簡単に見分け、厚さのフリンジに基づいて層の厚さを決定できます。
さらに、高度なモデリング技術により、段階的構造の シゲ 層などの構造的特徴を正確に記述することができます。人事部-XRD は、AlGaAs、InGaAs、InGaN などのさまざまなエピタキシャル材料を測定できます。XRDは、これらの薄膜層の組成を 1% 未満の精度で決定できます。ただし、人事部-XRD では、すべてのドーピング原子が格子内に存在すると仮定していることに注意してください。
